文章目录[隐藏]
随着互联网3.0的兴起,带宽需求呈指数增长,将推动针对云数据和电信提供商数据移动互连的不断创新和部署。因此,在未来十年中,高度集成的硅光子平台解决方案有望成为云数据和电信市场的关键支持技术。
高度集成的硅光子平台对基础设施业务意味着什么?
随着速率的不断提高,光纤将取代铜缆成为云数据中心内部主要传输介质。硅光子技术的发展,可以补充数据中心互连中的高速CMOS技术,加速这一转变。
- 硅光子解决方案已经成功地在100G云数据中心内部署,可以与传统的“芯片和线缆”分离解决方案竞争。预计硅光子将随着云提供商过渡到下一个400G比特率时获得市场份额。
- 集成的硅光子平台解决方案在波特率不断提高的情况下,具有优于传统封装解决方案的固有优势。
- 超大规模数据中心的电源和散热能力有限,无法用于服务器互连。集成技术在节省空间和功耗方面很有优势。
- 与传统的“芯片和线缆”光学行业相比,将光学组件集成到硅中介层上可以充分利用大型自动化电子组件系统的成本优势。
- 随着数据中心规模的扩大,集成技术将进入交换机和服务器之间的连接,以及服务器内部的连接。
光互连封装
图1显示了过去20年中高速光口的演进。在此期间,可插拔模块主导了光互连领域。
- 每单位带宽的功耗降低了30倍以上。
- 每单位体积的带宽密度增加了10倍。
- 从20年前的GBIC的千兆位数据速率到现在的DR4/FR4模块的400Gbit/s数据速率,每个模块的带宽已增加了400倍。
以上成就是通过电子器件,光学组件和封装的不断改进而实现的。光引擎是不断缩小的光学接口的下一步发展。
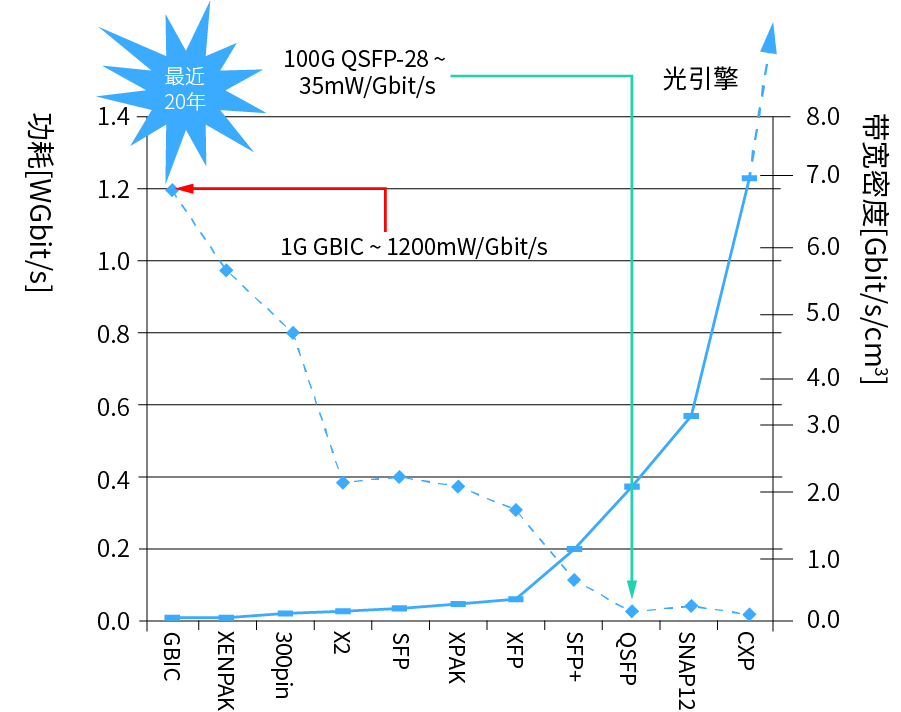
图1:光模块的演变
集成硅光引擎
近年来,人们一直非常关注硅光子平台上的异质集成。
随着交换机容量从当前的12.8TBit/s增加到51.2TBit/s,将光口置于在同一封装内的交换机附近,可降低功耗,并继续保持交换机带宽的扩展能力。实现这些小型化的光互连将基于硅光子技术,并且将驱动电子设备和激光器异质集成在同一衬底上。这种异质集成将使电子器件的性能不受光器件的影响而得到优化,这对于高度集成的数据中心互连模块至关重要。高度集成光引擎由具有光学组件的硅光子基板,利用2.5D多维度空间设计,将DFB激光器以及使用SiGe技术制成的调制驱动器和跨阻放大器(TIA)异质集成在一个芯片中,解决空间限制。以I品牌模块为例:
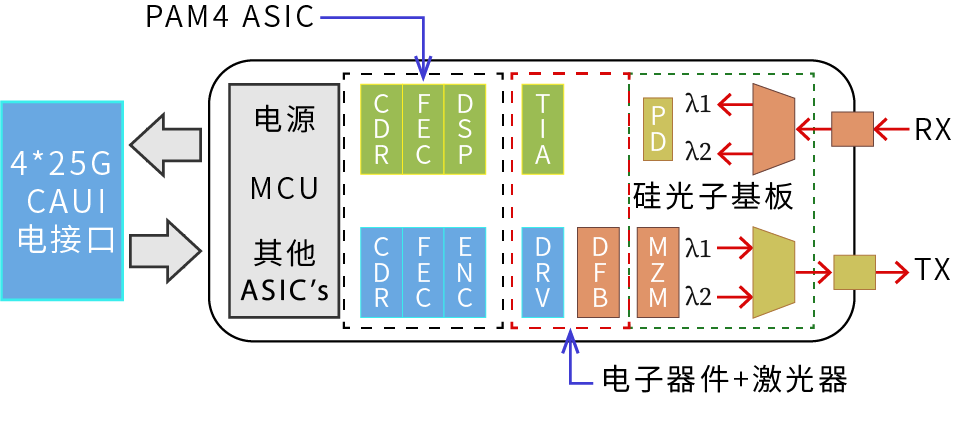
图2:2λ, 100Gbit/s, QSFP28硅光引擎框图
图2显示了基于高度集成的2λ,100Gbit/s,PAM4光引擎的框图,该引擎基于高度集成的硅光子芯片和专为数据中心内部互连(可达80km)设计的PAM4 DSP。这里的TIA,驱动器和DFB(显示在红色虚线框中)与硅光子芯片是分开的,并通过导线键合到其上。这是I品牌模块的基本架构,将QSFP28模块的占用面积缩小到单个集成芯片中的光引擎实现。
为了创建2.5D集成芯片,首先为TIA和驱动器镀上Cu-Ni-SnAg凸块,然后如图3左侧所示进行回流,以进行倒装芯片配置。如图3的右侧所示,对与电子设备相连的硅光子芯片上的焊盘进行CuNiAu电镀,然后将AuSn焊料沉积在硅光子芯片上以进行DFB激光附着。使用高精度倒装芯片键合机将TIA和驱动器放置在重新设计的硅光子芯片上,并使用标准SMT工艺在260°C的回流炉中进行连接。
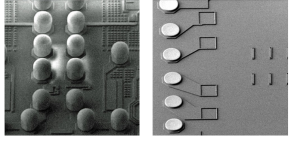
图3:电子器件被“撞上”,而硅光子被“镀上”
然后将CWDM波长的DFB激光器以较高的温度连接到光引擎上,用于AuSn焊料。单层去耦电容器和旁路电容器也包括在硅光子衬底上,这极大地简化了基于光引擎的光学模块的设计。
图4中的2.5D组件比迄今已展示出的更为紧凑,现已展出的光引擎仅包含集成在硅光子衬底上的光源。
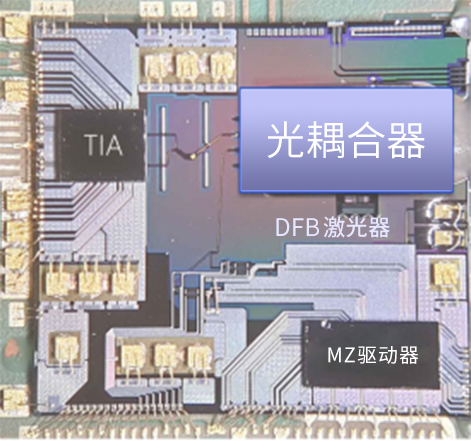
图4:2.5D光引擎
图5显示了测试光引擎的设置。PCB本身很简单,它只有射频走线和电容器。一组平行纤维被环氧树脂附着在光引擎上,用于光发射输出和接收输入。PAM4数据通过RF电缆(在图5的顶部)提供。TIA输出也通过更靠近图4右侧的RF电缆连接到测试设备,DFB激光器使用外部探针偏置,它们可能像TIA和驱动器一样被引线键合。

图5:光引擎测试设置
为超大规模数据中心互连应用提供高度集成,低功率硅光子平台的竞赛才刚刚开始。下一代将需要DSP、电子、光学和多维集成方面的不断进步。
资料来源:Inphi
往期回顾:硅光技术在相干模块中的应用前瞻
