上周,我们介绍了硅光应用在数据中心的优势以及现状(回顾前文),今天,我们就来介绍一下,硅光子的重要的技术革新:协同封装光子(co-packaged optics,CPO)技术。
共封装光学(以下简称CPO),英文名为co-packaged optics或者in-package optics,仅仅从这个名字出发,感觉似乎少了点什么,光学和谁封装在一起?其实,这个词后面应该加几个单词,with eletronics或者with ASIC,这样就比较好理解了。直白一点讲,就是将光收发器/光引擎和电芯片封装在一起,只保留光口,而不是采用可插拔光模块的形式。而采用硅光子的CPO技术是指把硅光模块和CMOS芯片用高级封装的形式(例如2.5D或者3D封装)集成在一起,从而在成本、功耗和尺寸上都进一步提升数据中心应用中的光互连技术。

图1:CMOS硅光子芯片
在CPO技术兴起之前,传统技术是把硅光模块和CMOS芯片独立成两个单独模块,然后在PCB板上连到一起。这么做的优势是设计较为模块化,硅光模块或者CMOS芯片其中一个出问题都可以单独更换。但是在功耗、尺寸和成本上都较为不利。例如,由于硅光模块的输出是超高速数据,这些数据使用PCB板连接到CMOS芯片上会遇到较大的信号耗损,因此需要高功耗才能支持高数据率;此外,成本上要设计支持超高速信号的PCB也需要较高的开销;而在尺寸上来说分立的硅光模组和CMOS芯片通常集成度更低,这也限制了进一步提升数据中心中的服务器密度。
而CPO技术可以解决这些问题。当使用高级封装技术把硅光模块和CMOS芯片集成到同一个封装内之后,首先硅光模块和CMOS芯片之间的数据连接质量(信号耗损)相比PCB板来说要改善不少,因此能降低功耗;另一方面,在大规模量产之后,高级封装也能带来成本上的改善。最后,使用CPO之后,由于都集成在同一个封装内,整体系统的集成度大大提升,尺寸减小,因此也能提升硅光子技术在数据中心应用场景的普及。
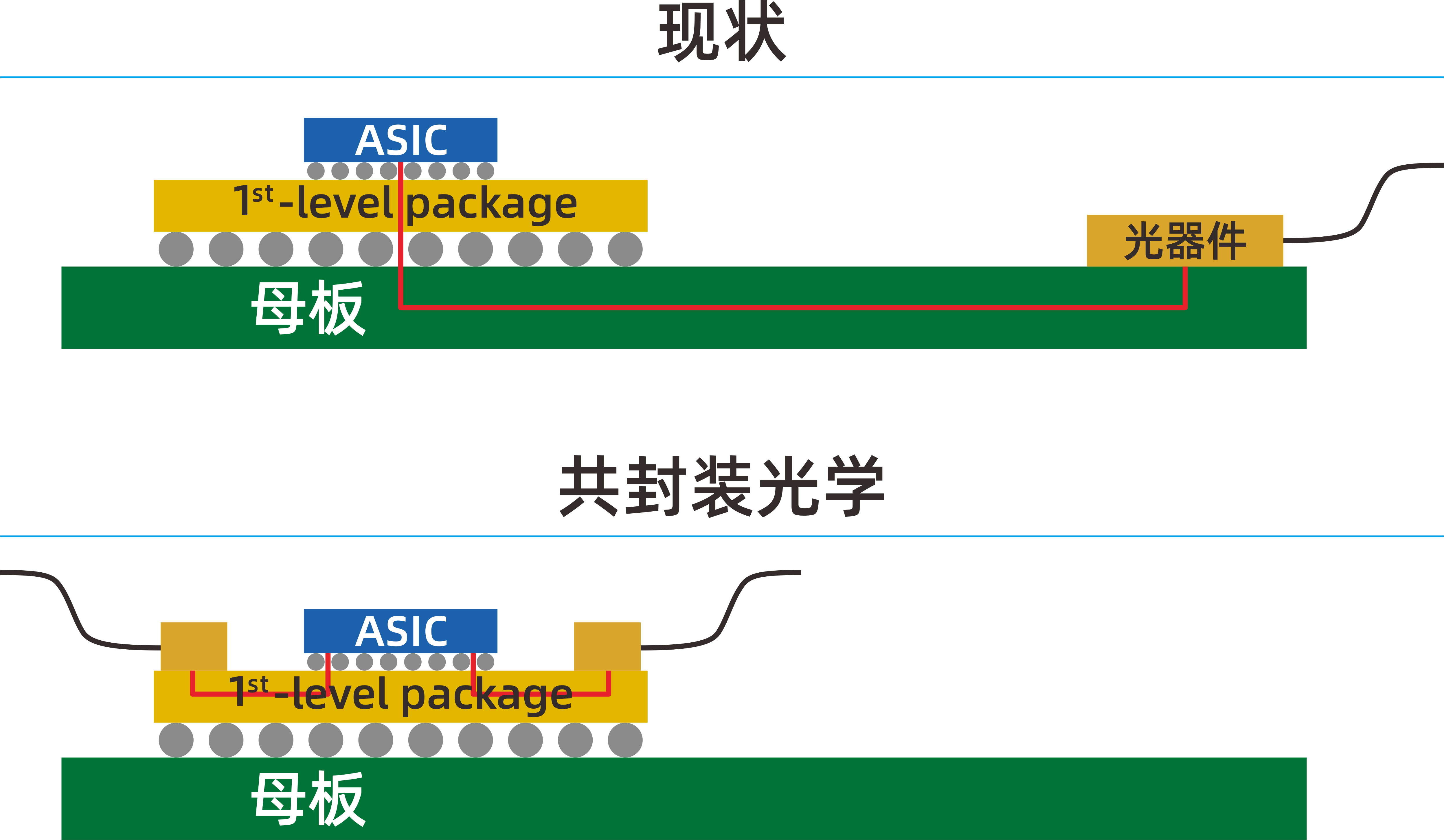
图2:硅光模块的CPO封装
通过 Co-packaging 的封装方式,大体积的可插拔模块被简单的光纤配线架所取代,因此前面板的物理拥塞得以缓解。更重要的是,交换机和光学器件之间的电气通道大大缩短,因此功耗得到大幅降低。根据Ayar Labs数据,如图3,以 32×100Gbps为例,现在所使用的交换机功耗436W,而CPO交换机通过共同封装大幅度缩短电连接,功耗仅230W。

图3:CPO交换机
并且,CPO技术是采用硅光子实现光学 I/O 的第一步,采用硅光技术可以轻松突破现有带宽的瓶颈,并且在核心交换设备接口方面已经有规模化的应用。
随着数据中心中的CPO技术崛起。Light counting预测,与交换ASIC共同封装的光引擎可能会为大型数据中心的可插拔光收发器提供替代方案。当网络速度提高至800Gbps以上,可插拔光组件将遭遇密度和功率问题,CPO成为业界亟需的封装替代方案。在未来,硅光子的主要技术演进将集中在更高集成度,以及和CMOS芯片的封装上面,而先进的硅光子制造工艺以及封装技术将会成为硅光子技术演进的核心技术支撑。
-End-
内容来源:
硅光前景展望,半导体行业观察
硅光子技术在通信光模块中的应用研究,中国通信标准化协会
